-
Group News2023-05-17
- 对话顶级键合技术专家:晶圆键合如何超越摩尔定律?|甲子光年

半导体行业的“嫁接”技术。
作者|赵健
摩尔定律是指导半导体产业发展的圭臬。半个世纪以来,集成电路上可容纳的晶体管数量基本遵循每隔18-24个月翻一倍、同时芯片成本下降一半的规律发展。
但今天,随着芯片制程迈入5nm甚至3nm,在物理规律的限制下,摩尔定律已经逼近极限,继续在二维平面缩小晶体管的特征尺寸来提升芯片性能变得越来越困难。
因此,从二维平面向三维集成的新型结构发展,成为超越摩尔定律、推动半导体行业发展的重要方向。
“晶圆键合”就是3D集成技术的一种。
虽然热度比不上光刻机、EDA等半导体概念,但晶圆键合在MEMS(微机电系统)、CMOS(图像传感器)、DRAM(动态随机存取内存)和NAND(计算机闪存)等领域有着广泛的应用。
晶圆键合是半导体行业的“嫁接”技术,通过化学和物理作用将两块已镜面抛光的晶片紧密地结合起来,进而提升器件性能和功能,降低系统功耗、尺寸与制造成本。
由于晶圆键合在3D集成方向的巨大潜力,英特尔、三星、华为、高通、罗姆、台积电等知名企业及众多高校、科研院所均围绕晶圆级封装键合开展了设备、器件、工艺的研究。
比如,英特尔在2022 IEEE国际电子器件会议上,发布了新的3D混合键合(hybrid bonding)技术,将功率密度和性能提升了10倍。
在国内,晶圆键合也是新兴的半导体创业方向。成立于2020年,曾受华为哈勃投资的中科晶禾是代表公司之一。
中科晶禾的母公司青禾晶元,其首席科学家须贺唯知是日本东京大学名誉教授,原日本电子封装学会会长,也是晶圆键合的泰斗级人物。须贺教授在20世纪90年代就开始研究的常温晶圆键合,是当下最先进的键合技术方向。
近期,「甲子光年」采访了须贺教授,探讨了晶圆键合在超越摩尔定律、推动半导体行业发展所产生的影响。
1.晶圆键合:超越摩尔定律的核心技术之一

甲子光年:对于半导体产业链,最简单的分类通常是芯片设计、芯片制造、芯片封测三大环节。您能否通俗地解释一下“键合”在半导体产业链中的位置,以及所发挥的作用吗?
须贺唯知:半导体产业从技术角度可分为“前工序”和“后工序”,而键合技术被视为“后工序”和“封装”的一种技术。然而,随着近年来半导体微缩化的极限和集成化的障碍,人们开始认识到3D集成化作为一种超越以往技术壁垒的重要技术。
在传统的半导体产业链中,设计、制造和封测是相对独立地进行,但现在情况有所改变。考虑到整体系统的集成,键合需要在前工序中进行讨论,而不再局限于后工序,否则整个系统将无法完成。这使得整个过程变得紧密无缝。
在半导体产业中,键合作为先进封装技术的核心技术起着重要作用。在3D集成中,键合技术是DRAM存储器和NAND存储器堆叠的关键技术。此外,逻辑芯片和存储器的堆叠也离不开键合技术的支持。此外,Si-Photonics和光子学领域的新型器件也依靠键合技术来实现。
甲子光年:键合技术的物理与化学原理,实际上早在人类切出第一片晶圆前就已经被发现和应用了。但晶圆键合真正的大规模工业应用,是从20世纪90年代之后才开始。原因是什么呢?
须贺唯知:自从贴合晶圆SOI(Silicon-on-Insulator)实用化之后,晶圆键合技术才开始真正被应用。在此之前,几乎没有工业领域使用晶圆键合技术。之后,由于MEMS封装、SAW滤波器、Si-Photonics等工业领域的出现,需要依赖键合技术来实现的领域才逐渐增多。
甲子光年:晶圆键合有很多分类,能否先帮我们梳理一下键合的种类?
须贺唯知:键合方法可以分为在键合材料之间加入焊料等互连中间层的键合方法,和无中间层的直接键合的方法。
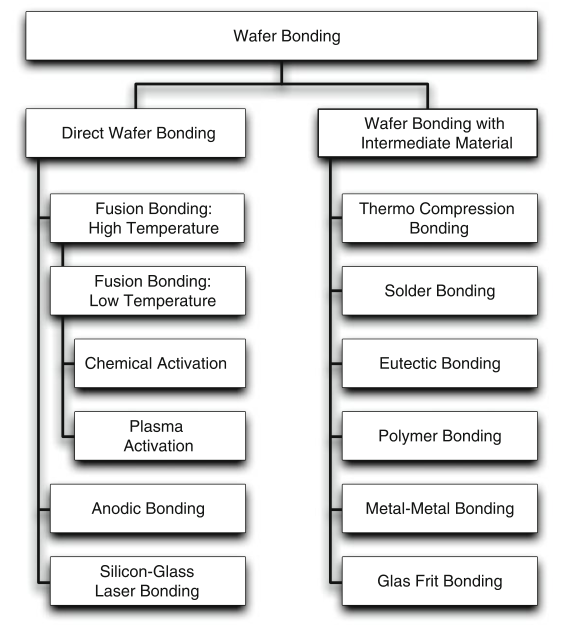
在Si和SiO2晶圆键合中,主要使用的是亲水性键合(Hydrophilic Bonding),它可以在大气环境下进行键合,因此被广泛应用,但需要加热至350°C;而表面活性化键合(Surface Activated Bonding,SAB)则需要真空环境,但可以在常温下进行键合。
目前,已经开始研究将这两种方法结合的Modified SAB。对于金属等的直接键合,SAB是一种常温键合方法,而传统的加热方法包括热压键合(Thermocompression Bonding, TC Bonding)和扩散键合。
甲子光年:须贺教授也是从20世纪90年代开始研究键合技术,就直接挑战特别前沿的常温键合技术,在当时应该超出了很多人的理解和想像,您当时的出发点和动机是怎样的?
须贺唯知:键合本身是一种利用物质表面具有高表面能量特性的简单方法。然而,传统的技术并不使用这一特性,而是通过加热利用热活化过程中的化学反应。但是这样做会在键合界面产生热应力和脆性反应层,降低强度和可靠性。为了充分利用表面的特性,必须将表面清洁至极致(表面活化),这就需要超高真空等环境,但真空设备成本非常高。当时,工业界对此不感兴趣,学术界也未意识到其与研究经费相匹配的必要性。
我为什么选择更具挑战性的常温键合,这个问题有点难以回答。但我个人在各种研究中,更喜欢这种不走寻常路的方式。我更关注问题本身,而不仅仅是解决问题的方式。我认为只有这样,才能得到好的结果。我也一直这样告诉我的学生们,思考问题不要循规蹈矩。我一直坚信,在研究任何事物时,忠实于原理才是捷径。在某种意义上,我可能有些笨拙,但也可能是因为我喜欢这样的方式,所以选择了这个挑战。但从结果来看,也许是好的。
甲子光年:常温键合的优势与挑战有哪些?
须贺唯知:常温键合的优点在于可以在常温下完成键合过程。因此,与通过加热进行键合的方法相比,常温键合可以无问题地实现异种材料的键合,而避免了热应力和反应导致的键合困难。
不论是传统的高温晶圆键合还是常温键合,挑战在于需要非常平坦的晶圆表面(表面粗糙度在1纳米以下),这也是成本最高的环节之一。目前有各种各样的新尝试正在进行中,不仅仅是物理层面的研究,还包括使用离子束或等离子体等新技术的应用。
甲子光年:常温键合对于传统的高温键合是一种替代关系吗?还是并行关系?
须贺唯知:是并行关系。在目前情况下,普通的键合技术可以满足的需求,没有必要刻意转向常温键合技术。但是过去做不到的事情可能会使用新的技术,我们可以将新的需求和新的应用领域作为发展方向。
甲子光年:在过去的二十多年以来,键合技术,特别是常温键合技术,取得了哪些重要的进展?有哪些重要的节点性事件?
须贺唯知:最初,我们进行了金属-金属和金属-陶瓷的表面活性化常温键合。在1996年,我们首次实现了硅晶圆键合,1997年证明了化合物半导体的异质键合。在2001年的IEEE-ECTC学术会议上,我们首次提出了Cu-Cu(铜-铜)直接键合的“无凸点互连”(Bumpless-interconnect)概念,这也成为了当前混合键合(Hybrid bonding)技术的基础,并被评为IEEE-ECTC的最佳论文。
在2010年,我们提出了一种改进的表面活性化常温键合方法,其中包括用于硅的中间层纳米粘附层,从而实现了之前无法实现的玻璃和聚合物薄膜的常温键合。
此外,自1998年起,我们与日本的11家半导体公司以及产学联盟合作,这种与产业界的合作至今仍在继续。
在产业界,2012年欧姆龙公司开始使用Si表面活化键合量产制造MEMS传感器。索尼公司从2016年开始量产CMOS图像传感器。很可能从今年开始,表面活化键合技术将在混合键合中得到广泛应用。
甲子光年:国际上游哪些公司在键合技术方面还有比较突出的优势?
须贺唯知:在键合设备领域,奥地利的EVG公司占据了很大的市场份额;但在表面活化键合方面,目前只有日本的几家制造商。
甲子光年:您认为键合的发展方向有哪些?您理解的未来的键合技术是什么样的?
须贺唯知:常温键合的技术基本上已经成熟了。然而,用于实际应用的设备以及调节参数等方面还远未完成。由于存在各种不同的应用场景,这些问题将在未来逐渐解决,并变得更加易于使用。目前大家对此还不太了解,有些人可能会觉得这个概念很陌生。现在只有一两台定制设备,而且大家也不太清楚如何使用。但我相信随着推广普及,这些问题将逐渐得到解决。
2.与中国半导体结缘

甲子光年:您与中国半导体产业的合作,最早是从什么时候开始的?当时的契机是什么?
须贺唯知:2005年,东京大学在中国设立了其驻中国代表处(位于无锡),我们进行了各种交流,但遗憾的是,没有推动有效的产业化。
从2012年开始,我成为中国科学院微电子研究所的客座教授,在研究领域进行了许多交流。但我认为与中国的半导体产业合作还需要更多的时间。
甲子光年:键合技术在中国的发展现状是怎样的?有哪些公司做的不错?
须贺唯知:据我所知,在清华大学等地,使用激光等先进的键合技术正在得到发展。然而,在工业界的技术方面,我对中国的独特技术了解不多。青禾晶元是其中一家我了解的公司,对于青禾晶元的发展,我也抱有期待。
甲子光年:您是青禾晶元的首席科学家。这个合作是如何开始的?契机是什么?
须贺唯知:在东京大学过去35年的键合研究中,超过多名中国留学生(博士生)做出了许多贡献。其中之一是青禾晶元公司的母凤文(青禾晶元总经理)。他成功地利用表面活化键合技术进行了SiC、GaN和金刚石等新型材料的键合研究。我认为这些工作是青禾晶元成立的契机之一。
甲子光年:您对青禾晶元这家公司印象最深刻的一点是什么?
须贺唯知:虽然青禾晶元成立只有3年,但他们迅速将技术转化为产品,还融入了许多新的想法,因此可以期待其取得巨大的发展。
甲子光年:日本在半导体材料、设备等领域处在世界领先的位置。您能否从个人感受的角度来对比一下,中日半导体行业的发展以及对中国半导体行业提出建议。
须贺唯知:日本在半导体材料和设备等领域处于世界领先地位。然而,半导体技术并不仅仅是购买设备然后排列起来就能实现的。我认为通过自我挑战,才能孕育新的智慧、技术和产业。资本的力量固然重要,但培养人才、自主开发技术比任何事情都重要。
这可能更像是对日本产业界逐渐衰落的警钟,而不仅仅是对中国半导体产业的建议。
-
Latest News

- 2025-05-01
- Pay tribute to the strivers in the semiconductor industry and wish you a happy May Day!
-
Latest News

- 2025-04-21
- iSABers Co-hosted – 2025 China International Seminar on Low-Temperature Bonding and 3D Integration Technology Invites You to Participate
-
Latest News

- 2025-03-28
- iSABers SEMICON Moment: Offline Innovation Sharing Session Successfully Held
-
Latest News

- 2025-03-27
- iSABers' SEMICON Moment: Showcasing China's Solutions for Advanced Bonding Technology
-
Latest News

- 2025-03-21
- SEMICON In-Person Advanced Bonding Technology Breakthroughs Symposium